原子层刻蚀和沉积工艺利用自限性反应,提供原子级控制。泛林集团先进技术发展事业部公司副总裁潘阳博士分享了他对这个话题的看法。
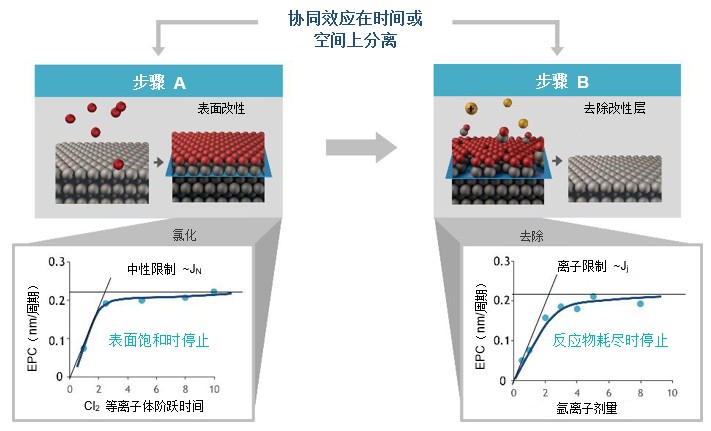
图 1. 原子层工艺中的所有半周期反应是自限性反应。
技术节点的每次进步都要求对制造工艺变化进行更严格的控制。最先进的工艺现在可以达到仅7 nm的fin宽度,比30个硅原子稍大一点。半导体制造已经跨越了从纳米级到原子级工艺的门槛。工程师现在必须关注结构的尺寸变化,仅相当于几个原子大小。由于多重图案模式等复杂集成增加了工艺数量,进一步限制了每个步骤允许的变化。3D NAND和finFET结构的复杂性会带来更高挑战。
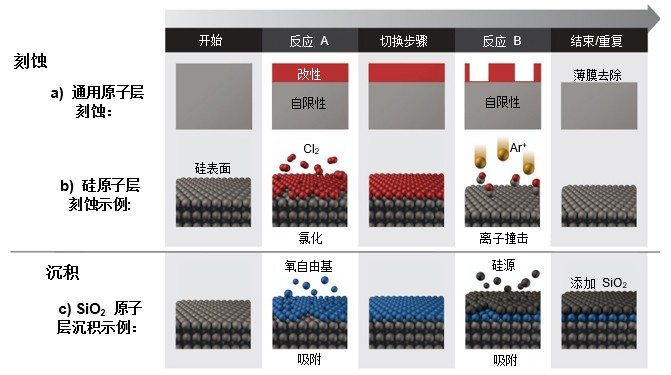
图 2. 原子层工艺能够去除或沉积材料。在以上刻蚀示例中,氯吸附到硅表面,然后通过氩离子撞击去除改性层。在沉积示例中,氧吸附到硅表面,硅与改性表面层相结合,沉积二氧化硅。
对于半导体行业而言,控制工艺变化始终都是一大关键挑战,因为它会直接影响到产品的性能、良率和可靠性,进而产生重大经济后果。工艺诱生的变化有多个来源,包括晶粒、晶圆和工具。要控制这些变化,一种方式是通过运用原子层沉积 (ALD) 和原子层刻蚀 (ALE) 等技术,这些技术本身比传统等离子体方法更加精确。
原子层工艺
原子层工艺包括沉积和刻蚀解决方案,它们具有一些共同的特征。与连续工艺不同,它们分周期进行,每个周期都会添加或去除有限固定数量的分子层。每个周期又分为若干半周期,每个半周期分别是不同的自限性工艺,为下个半周期准备表面。例如,在 SiO2 沉积中(图1和2),第一个半周期会吸附氧原子,这个过程是自限性的,受到结合位点的限制。然后,多余的氧被从腔室中清除,表面暴露在硅原子源下,硅原子与吸附的氧发生反应,形成一层 SiO2。这个半周期工艺也是自限性的,在这种情况下,它受到氧的限制。原子层沉积的自限和有序的特性在先进逻辑和存储器芯片HVM中得到了广泛应用。
与沉积技术相同,原子层刻蚀同样分为若干半周期进行,这些半周期也是自限性的。例如,在硅刻蚀工艺中,第一个半周期将硅表面暴露在氯下,氯与第一层硅原子结合,弱化它们与底层原子的键合(图2)。当表面饱和时,该过程停止,然后清除未使用的氯。第二个半周期使用氩离子来撞击改性表面,去掉氯激活的硅顶层,而不是底层硅。氯化层去掉之后,周期完成,薄材料层已精确去除。
过去,要将原子层刻蚀工艺集成到大规模半导体生产中,我们会受制于相对连续刻蚀工艺来说较低的刻蚀速率。以下两个因素结合在一起,减少了较低刻蚀速率对整体产量的影响。第一个因素是特征尺寸持续减小,从而减少了要去除的材料数量,以及所需的ALE周期数。第二个因素是ALE技术的进步,例如快速气体交换技术,它们显著提高了循环速度。随着我们越来越多地需要对较小结构实现原子级控制,这种技术引起了更多关注。原子层刻蚀还提供了其他一些重要优势,包括改进的方向性(异向性)、更光滑的表面、更好的材料选择性、更均匀的刻蚀表面、较少的表面损坏和混合,消除了图案密度引起的非均匀效应,并改进了晶圆间的均匀性。
创新的原子层刻蚀与原子层沉积技术解决方案
EUV 光刻技术中的随机缺陷
在7nm和10nm节点采用EUV光刻技术的制造商面临着随机缺陷的挑战。EUV光的较短波长使其能够聚焦至更精细图案,但也意味着每个光子具有更多能量,产生更多光致酸,同时曝光更大量的光刻胶。EUV系统非常昂贵,而且必须实现较高的产量才能在成本基础上与传统 (i193) 光刻技术进行竞争,因此它们采用短曝光、低光子剂量以及以最小量光子就可以实现曝光的化学放大光刻胶 (CAR)。光刻胶中光子与光致酸在空间与时间分布上的随机变化性会导致随机缺陷,这本质上是一种统计块度,在已创建的光刻胶图案中体现为边缘和表面粗糙度。圆形边缘粗糙度 (CER) 以及线边缘粗糙度 (LER) 均是边缘定位误差 (EPE) 的组成部分,最终限制了特征尺寸可能减少的程度。在先进节点中,50% 以上的BEOL区域是为EPE保留的;设备扩展受到EPE扩展的限制而且需要节点对节点EPE下降30%(图 3)。
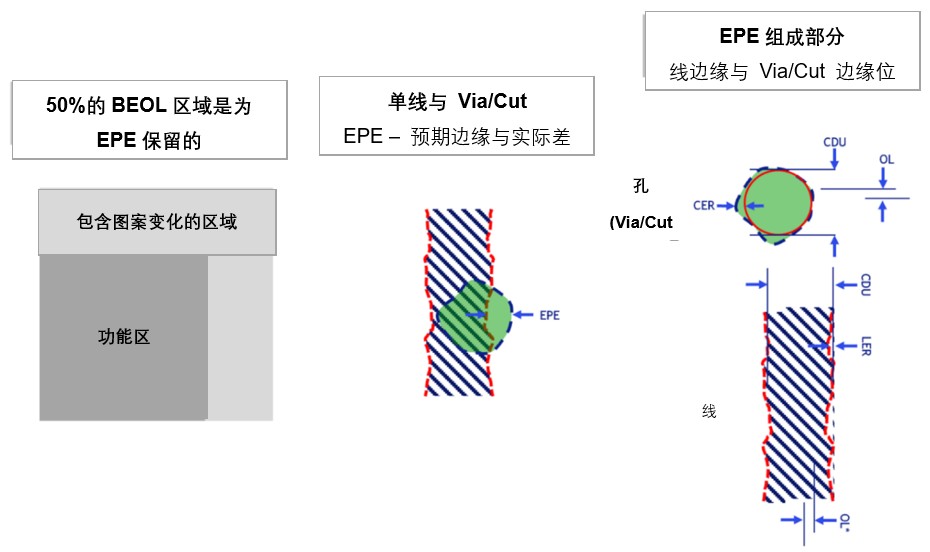
图 3. 边缘放置误差 (EPE) 最终限制空间扩展。50%的BEOL区域是为EPE保留的。因EUV光刻技术中随机缺陷引起的线和圆形边缘粗糙度极大地促进了EPE的产生。