对Fab工厂而言,控制晶圆、电子化学品、电子特气和靶材等原材料中的无机元素杂质含量至关重要,即便是超痕量的杂质都有可能造成器件缺陷。
然而半导体杂质含量通常在ppt级,ICP-MS分析时用到的氩气及样品基体都很容易产生多原子离子干扰,标准模式、碰撞模式下很难在高本底干扰的情况下分析痕量的目标元素。
半导体专用ICP-MS,凭借其独特的以动态反应池技术为基础的UCT(通用池)技术,既能实现标准模式、碰撞模式,也可以通过反应模式消除干扰,从根本上成功解决了多原子干扰的技术难题。
晶圆中的金属杂质分析(UCT-ICP-MS)
晶圆等半导体材料中的主要成分是硅。高硅基体的样品在传统的冷等离子体条件下分析,其中的耐高温元素硅极易形成氧化物。这些氧化物沉积在锥口表面后,会造成明显的信号漂移。NexION系列半导体专用ICP-MS在高硅基体的样品分析中采用强劲的高温等离子体,大大降低了信号漂移。通过通入纯氨气作为反应气,在DRC 模式下,有效消除了40Ar+ 对40Ca+、40Ar19F+ 对59Co+、40Ar16O+ 对56Fe+ 等的干扰。通过调节动态带通调谐参数消除不希望生成的反应副产物,克服了过去冷等离子体的局限,有效去除多原子离子的干扰。在实际检测中实现了10 ng/L 等级的精确定量,同时表现出良好的长期稳定性。
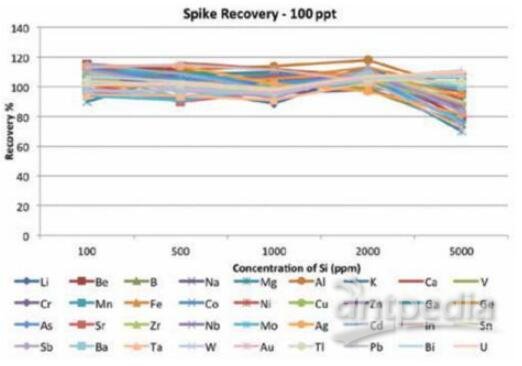
基质耐受性:Si 基质浓度为100ppm 到5000ppm 样品100ppt 加标回收

稳定性:连续进样分析多元素加标浓度为100ppt 的硅样品溶液(硅浓度为2000ppm)

ICP-MS 测定半导体级盐酸中的金属杂质
在半导体设备的生产过程中,许多流程中都要用到各种酸类试剂。其中最重要的是盐酸(HCl),其主要用途是与过氧化氢和水配制成混合物用来清洁硅晶片的表面。由于半导体设备尺寸不断缩小,其生产中使用的试剂纯度变得越来越重要。
ICP-MS具备精确测定纳克/升(ng/L,ppt)甚至更低浓度元素含量的能力,是最适合测量痕量及超痕量金属的技术。然而,常规的测定条件下,氩、氧、氢离子会与酸基体相结合,对待测元素产生多原子离子干扰。如,对V+(51) 进行检测时去除 ClO+ 的干扰。虽然在常规条件下氨气与ClO+ 的反应很迅速,但如果需要使反应完全、干扰被去除干净,则需要在通用池内使用100% 纯氨气。NexION系列半导体专用ICP-MS的通用池为四级杆,具备精准可控的质量筛选功能,可以调节RPq 参数以控制化学反应,防止形成新的干扰,有效应对使用高活性反应气体的应用。

20% HCl 中各元素的检出限、背景等效浓度、10 ng/L 的加标回收率

20% HCl 中典型元素ppt 水平标准曲线

20% HCl 中加标50 ng/L 待测元素,连续分析10 小时的稳定性
电子特气直接进样分析技术(GDI-ICP-MS)
半导体所使用的特殊气体分析传统方法有两种:一种是使用酸溶液或纯水对气体进行鼓泡法吸收,然后导入ICP-MS进行分析;另一种是使用滤膜对气体中颗粒物进行收集,然后对滤膜消解后上机。然而无论是鼓泡法吸收还是滤膜过滤收集、消解,都存在样品制备过程容易被污染、鼓泡时间难以确定、不同元素在酸中溶解度不一样等各种问题,分析结果的可靠性和重现性都难以保证。
GDI-ICP-MS系统可以将气体直接导入到等离子中进行激发,避免了额外的前处理步骤,具有方便、高效、不容易受污染等特点,从根本上解决传统方法的一系列问题。
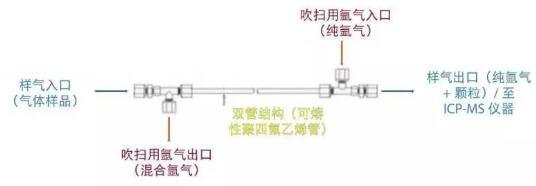
GDI-ICPMS气体直接进样技术

GDI-ICPMS 直接定量分析气体中金属杂质

GDI-ICP-MS法绘制的校准曲线(标准气体产生方式:在氩气中雾化标准溶液,这些标气对所有待测元素的线性都在0.9999以上)
半导体有机试剂中纳米颗粒的分析(Single particle-ICP-MS)
单颗粒ICP-MS(SP-ICP-MS)技术已成为纳米颗粒分析的一种常规手段,采用不同的进样系统,能在100~1000 颗粒数每毫升的极低浓度下对纳米颗粒进行检测、计数和表征。除了颗粒信息,单颗粒ICP-MS 还可以在未经前级分离的情况下检测溶解态元素浓度,可检测到ppb级含量的纳米颗粒,实现TEM、DLS等纳米粒径表征技术无法完成的痕量检测。
用ICP-MS分析铁离子(56Fe+)时会受到氩气产生的40Ar16O+的严重干扰。利用纯氨气作反应气的动态反应池技术是消除40Ar16O+对铁离子最高丰度同位素56Fe+干扰最有效的途径,而只有对56Fe+的分析才能获得含铁纳米颗粒分析最低的检出限。

90% 环己烷/10% 丙二醇甲醚混合液测定图谱,有含铁纳米颗粒检出

TMAH 中含铁纳米颗粒结果图谱:(a)粒径分布;(b)单个含铁纳米颗粒实时信号
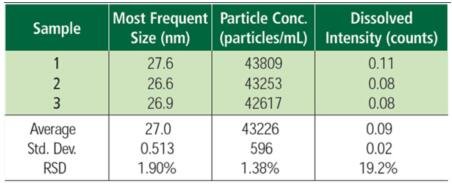
TMAH 中含铁纳米颗粒粒径和浓度

由Fe(OH)2 到总铁的质量换算
SP-ICP-MS技术测定化学-机械整平(CMP)中使用的元素氧化物纳米颗粒悬浮物的特性
氧化铝和氧化铈纳米颗粒常用于纳米电子学和半导体制造行业中化学-机械 (CMP)半导体表面的平整。CMP悬浮物纳米粒子的尺寸分布特征以及大颗粒的辨别,是光刻过程质量控制的重要方面,会影响到硅晶片的质量。既可以测量可溶分析物浓度、又能测定单个纳米粒子的单颗粒模式ICP-MS(SP-ICP-MS)是分析金属纳米粒子的最有前途的技术。
SP-ICP-MS技术具有高灵敏度、易操作、分析速度快的特点,纳米粒子引入等离子体中被完全电离,随后离子被质谱仪检测,信号强度与颗粒尺寸有关。因此SP-ICP-MS可为用户提供颗粒浓度(颗/mL),尺寸大小和尺寸分布。为确保一次只检测一个单颗粒,必须稀释样品以实现分辨的目的。这就要求质谱仪必须能够有很快的测量速度,以确保能够检测到在50nm纳米颗粒的瞬时信号(该信号变化的平均时间为300~500μs)。珀金埃尔默NexION系列半导体专用ICP-MS单颗粒操作模式能够采集连续数据,无需设置定位时间,每秒钟获取高达100 000个数据点。结合纳米颗粒分析软件模块,可以实现单颗粒纳米颗粒的准确分析。

采集数据比瞬时信号更快的纳米信号积分图


悬浮物1~4归一化颗粒尺寸分布频次图