n1和n2表示每种材料的折射率,θ1和θ2是光线在每种材料中传播与表面法线形成的夹角(逆时针方向),并假设硅的折射率n
= 3.44,空气/真空的折射率n = 1。基于上述几何假设,预期视野角度FFOV = 80°-
82°。然后开始腔体封装的初步设计,并在封装试生产线实验室中制造了两个批次的原型。为了获得不同的FFOV,我们提出了两种不同的窗口设计。为了在1.0um
-13.0um波长范围内,验证封装腔壁材料的“ T%=
0”条件,做了模塑树脂材料的红外透光值测试。封装结构是系统级封装,其中ASIC裸片与MEMS红外传感器并排放置,裸片间通过引线键合(WB)连接,如下图所示。

图9:带红外光窗封装(左图)和一体式红外滤光封装(右图),通过表面贴装技术(SMT)焊接在DIL 24测试板上
使用前述的黑体辐射源,在距封装顶部22cm处,对上述两个系统封装进行表征实验。

图10:封帽上有小光窗的封装与封帽整体是红外滤光片的封装的MEMS红外传感器灵敏度对比
实验后,在22cm处,没有观察到小光窗和一体式红外滤光封帽之间存在灵敏度测量值差异,响应时间相同。选择该距离是为了使光束方向接近传感器上表面红外的平面入射波。为了进行FOV表征实验,鉴于传感器感光区置于黑体前面的正常条件,将传感器安装在从-90°到+ 90°的旋转台上。

图11:红外传感器的红外小光窗封装、一体式红外滤光封装和大陶瓷封装的FOV表征实验结果
在大陶瓷封装中,红外传感器的FFOV角度为109°±2°,小于朗伯分布的理论值(理论上为120°),这可能是MEMS 的硅嵌入结构所致。 小光窗封装的FFOV角度为88°。采用相同的封装旋转方法,一体式红外滤光模塑封装的FFOV为100°。在最后一种情况中,由于模塑封装腔壁靠近传感器感光区,观察到了不对称效应。
封装应力模拟
对于特定吸收功率,高热隔离度确保冷热端之间的温差最大化, 这是从热电堆获得大输出电压的重要因素。使用MEMS封装可以选择腔内气体,压力选择范围100Bar至100mBar。气体导热性会影响温度传导速度,以及热电堆冷热端之间的温差,进而影响输出电压变化和传感器效率。
MEMS封装是通过晶圆片间的引线键合技术实现的。MEMS传感器系统主要是由一个采用表面微加工工艺制造的硅微结构构成,通常是将两个或多个晶圆片(裸片)堆叠放置,用玻璃材料化合物焊料将其焊接在硅基封装内。
在传感器上存在厚度约为150um的硅保护帽,其本身对入射传感器表面的辐射有自然的红外波长过滤功能。当然,硅保护帽的红外透射光谱使传感器光学性能在1-13um波长红外区域变差12,具体程度取决于硅特性。
传感器开发需要将MEMS硅封帽集成在传感器晶圆上。我们模拟了由红外传感器、硅封帽、ASIC和封装构成的整个传感器系统。因为裸片堆叠安装在封装衬底上,传感器微结构与封装结构是一体的,因此,封装对传感器信号性能有影响。除了在工作过程中受到的应力外,在制造过程中,特别是封装焊接到PCB上后的冷却工序,还会出现临界情况。由于封装是由热膨胀系数(CTE)不同的材料制成,热梯度会引起翘曲现象,导致应力转移到传感器微结构,从而影响传感性能。
用SolidWorks Simulation软件建立了一个有限元3D模型,用于模拟在承载传感器微结构的硅衬底上出现的翘曲。焊接后冷却模拟考虑了将封装焊接在参考PCB上的情况。表3总结了热负荷和边界条件。图12是有限元模型。
表2列出了模拟所用材料的特性。
尽管知道模拟结果在很大程度上取决于材料模型和所用材料的特性,但考虑到封装模拟文献中的常规做法,我们还是假定了分析比较的目的、可用的材料数据以及所执行模拟的静态性质,材料的各向同性弹性。
为了减少计算时间,我们考虑创建一个简化模型。 但是,由于ASIC在封装内部的放置不对称,在封帽上有光窗,因此,需要模拟整个模型。对于封装上表面和下表面衬底层,等效机械性能计算方法如下14:

| (eq. 3) |
其中Eeff是有效杨氏模量,αeff 是有效热膨胀系数,分别是杨氏模量Ei, αi, Vi和CTE与构成材料的体积或面积百分比。图12是有限元模型,图13是传感器、ASIC和衬底上的翘曲模拟结果。承载传感器微结构的衬底的翘曲w定义为沿框架本身的位移z的最大值和最小值的差。
表2.材料特性

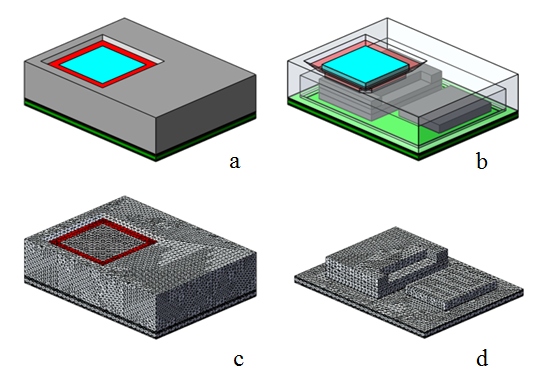
图12:热机械模拟有限元模型。a,b) CAD模型,c,d)有无封帽的有限元模型。 图中没有焊后模拟用的PCB板。